「GaN初識-1」神奇的「氮化鎵」
導 讀
在一些電力電子應用中,寬帶隙材料已開始取代硅。目前,氮化鎵(GaN)可能是電力電子領域最具挑戰(zhàn)性的技術(shù),它可以開發(fā)出功率密度更高、導通電阻更小、開關頻率極高的器件。
01.
氮化鎵初識
氮化鎵這種半導體材料的寬帶隙可產(chǎn)生高臨界電場,與具有相同額定電壓的硅基器件相比,可設計出漂移區(qū)更短的電子器件,從而降低導通電阻。由于開關速度高,在轉(zhuǎn)換器應用中,氮化鎵電力電子器件需要仔細設計功率回路布局。
此外,還必須采用適當?shù)姆庋b,以減少雜散電感,并對器件的高能量密度進行散熱。與具有相同電流和電壓速率的硅功率器件相比,芯片尺寸大幅縮小,而且目前可以達到很高的開關頻率(高達數(shù)十兆赫),從而可以減少功率轉(zhuǎn)換器的總體積。功率轉(zhuǎn)換器體積的縮小是轉(zhuǎn)換器與執(zhí)行器(如集成模塊化電機驅(qū)動器)集成的關鍵點。
開關功率損耗的降低為轉(zhuǎn)換器應用提供了越來越高效的解決方案,為不斷擴大的電力電子市場帶來了新的機遇。有多個電力電子應用領域受益于氮化鎵器件的技術(shù)進步,特別是在低壓(<200 V)電源領域,這些領域目前對現(xiàn)代社會的影響越來越大,如電信/數(shù)據(jù)通信、服務器 SMPS 和無線充電。
氮化鎵也是將可再生能源與電源轉(zhuǎn)換器、電動汽車、工業(yè)自動化和模塊化電池管理系統(tǒng)(BMS)進行集成的一項有利技術(shù),通常電壓較高(目前,650 V 是高壓氮化鎵的標準電壓,一些功率器件制造的最高電壓可達 1200 V)。上述所有應用中的寬帶隙半導體都改善了功率轉(zhuǎn)換器的功能,減輕了重量、體積,降低了生命周期成本。
此外,隨著人們對小型、長壽命、自主、電池供電的便攜式設備的需求日益增長,GaN 技術(shù)作為一種有吸引力的應對措施,在不久的將來肯定能得到廣泛應用。
在全球市場指數(shù)極具代表性的中國,消費電子應用領域的功率 GaN 器件市場預計將從 2021 年的 7960 萬美元增長到 2027 年的 9.647 億美元(資料來源:Power GaN 報告,Yole intelligence 2023)。

■ 圖1:GaN power electronic devices in long-term evolution for the Chinese market
(Source Power GaN report, Yole intelligence 2023)
圖 1 描述了氮化鎵器件向電力電子市場滲透的演變過程,重點介紹了它們的應用。目前,成本是主要限制之一,而可靠性和耐用性則隨著新一代器件的上市而逐步改善,這要歸功于應用設計師和工程師的不懈努力,他們強調(diào)了這些器件的局限性和應用機會。
02.
氮化鎵技術(shù):概述與發(fā)展
第一個氮化鎵器件于 2004 年左右問世,是由 Eudyna Corporation 在日本制造的耗盡型射頻 (RF) 晶體管。第一個半導體 RF 晶體管使用的是GaN-on-SiC。幾年后,基于GaN的技術(shù)開始應用于不同結(jié)構(gòu)布置的電力電子開關中。2009 年,Efficient Power Conversion (EPC) 開發(fā)出首款增強型氮化鎵場效應晶體管 (GaN FET)。從那時起,氮化鎵器件的發(fā)展就沒有停止過,目標也越來越遠大。
氮化鎵功率器件的發(fā)展時間表和主要參與企業(yè),如圖 2所示。

■ 圖 2. 氮化鎵電力電子器件里程碑和主要行業(yè)參與者。
氮化鎵功率器件是寬帶隙材料(WBG),屬于高電子遷移率晶體管(HEMT)。這些半導體電子晶體管的特點是由兩種具有不同原子間距和帶隙的晶體材料交界處產(chǎn)生的二維電子氣體(2DEG)。極化效應誘發(fā)異質(zhì)結(jié)(AlGaN/GaN)中的二維電子氣現(xiàn)象,從而導致電子的高遷移率。
多種因素促使功率開關設計人員投入大量精力制造 WBG 材料器件。為了更好地認識 WBG 功率器件先進性能背后的原因,圖 3a 對硅(Si)、碳化硅(SiC)和氮化鎵的重要材料特性進行了比較。圖 3 中的 SiC 器件采用的是 4H-SiC 技術(shù)。電力電子器件制造商使用這種技術(shù)是因為它具有各向同性的結(jié)構(gòu)。從圖 3a 中可以看出,與 Si 相比,WBG 材料具有更好的特性,如較高的熱導率、電子遷移率和擊穿電場。氮化鎵和碳化硅的性能各不相同,各有優(yōu)缺點,根據(jù)應用類型選擇其中一種更佳。
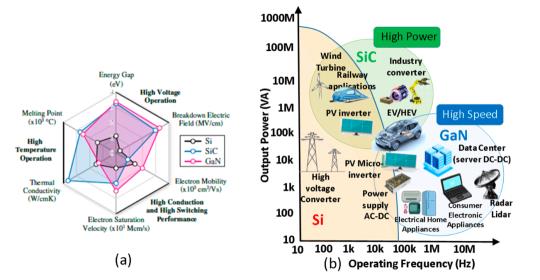
■ 圖 3.(a) 環(huán)境溫度 (25°C) 下 Si、4H-SiC 和 GaN 器件關鍵材料特性的雷達圖; (b) Si、SiC 和 GaN 電力電子開關應用領域。
氮化鎵的熱導率低于碳化硅,這種增強的導熱特性以更好的方式將熱量從半導體器件的結(jié)點傳遞到外殼。更好的導熱性能使 SiC 器件具有更高的電流/功率密度。相反,氮化鎵的主要特性是 HEMT 特性,這意味著晶體管溝道中的遷移率非常高。電子遷移率通常在 2000 cm2/Vs 左右,幾乎是碳化硅 MOSFET 的 100 倍。這是低導通電阻值的一個顯著優(yōu)勢。這樣就可以獲得面積更小的器件。此外,開關瞬態(tài)時間非常短,開關頻率比 SiC 器件更高。
經(jīng)過對上述器件技術(shù)的比較,可以斷言碳化硅器件具有更高的功率/電流密度。相比之下,氮化鎵器件的傳導損耗更低,開關頻率更高。如圖 3b 所示,器件的應用涵蓋了技術(shù)發(fā)展的不同領域,并有一些重疊。從成本角度來看,目前 SiC 材料的成本低于 GaN 材料。
大多數(shù)制造商采用硅基氮化鎵(GaN)結(jié)構(gòu),在其上使用大尺寸硅襯底進行氮化鎵外延層生長,以利用現(xiàn)有設施和技術(shù)并降低制造成本。目前的技術(shù)方法導致了具有橫向結(jié)構(gòu)的氮化鎵半導體功率器件的發(fā)展。在橫向結(jié)構(gòu)中,源極和漏極之間的電子流會在器件中形成不均勻的電場分布,在特定的器件區(qū)域會出現(xiàn)峰值;這種現(xiàn)象限制了其全面阻斷電壓的技術(shù)潛力。
當然,氮化鎵功率器件的垂直結(jié)構(gòu)正在開發(fā)中。與硅和碳化硅器件一樣,垂直設計可通過增加電壓阻斷層的厚度來提高擊穿電壓。垂直結(jié)構(gòu)是一種很有前景的解決方案,可在由碳化硅和硅器件主導的高壓市場中不斷擴大滲透率。要開發(fā)出具有競爭力的垂直 GaN 器件結(jié)構(gòu),必須克服一些問題,如 p-GaN 的離子注入和長期可靠性。
可靠性是 HEMT 器件進入大眾市場擴展功率應用的關鍵制約因素。制造商對器件的可靠性進行了深入研究,以達到并滿足保證氮化鎵結(jié)構(gòu)安全的標準。特別地,AlGaN晶體的制造可以被精確控制,不完美或意外缺陷會導致開關運行失敗。與氮化鎵器件的耐用性相關的另一個需要考慮的方面是開關運行期間的導通電阻 RDSon。
在開關模式功率轉(zhuǎn)換器中,氮化鎵功率晶體管的動態(tài)導通電阻(Dynamic-RDSon)會增加。在橫向 AlGaN/GaN 器件結(jié)構(gòu)中,與漏極側(cè)區(qū)域相鄰的柵極邊緣的電場量對動態(tài)-導通電阻的變化有很大影響。此外,相鄰的半導體狀態(tài)以及電子的注入和捕獲也會影響這些區(qū)域的退化,從而導致器件損耗和溫度的增加(GaN HEMT 結(jié)構(gòu)中的不良特征)。
近年來,氮化鎵功率晶體管設計人員一直在努力控制和減少這種現(xiàn)象,因為這種現(xiàn)象會導致功率轉(zhuǎn)換器在開關過程中出現(xiàn)嚴重的運行問題,并隨著開關過程中漏極電流(ID)的減小(稱為電流崩塌)而降低其性能。
其中一個例子是柵極注入晶體管(GIT)結(jié)構(gòu)的高電壓、常關GaN器件的出現(xiàn),它能有效解決動態(tài)RDSon的退化問題。該器件從 AlGaN/GaN 異質(zhì)結(jié)處的附加 p-AlGaN 層注入空穴,以釋放捕獲的電子,并通過大幅降低通態(tài)電阻來增加溝道中的電子密度。
OK,今天先更新到這里。下期「GaN初識」我們將從以下幾點出發(fā):
◎ 氮化鎵功率器件:分類和運行
◎ 氮化鎵結(jié)構(gòu)的集成
◎ 封裝解決方案
來源: 芯TIP
*聲明:本文由作者原創(chuàng)。文章內(nèi)容系作者個人觀點,寬禁帶半導體技術(shù)創(chuàng)新聯(lián)盟轉(zhuǎn)載僅為了傳達一種不同的觀點,不代表本聯(lián)盟對該觀點贊同或支持,如果有任何異議,歡迎聯(lián)系我們。
- 免責聲明
- 本文所包含的觀點僅代表作者個人看法,不代表新火種的觀點。在新火種上獲取的所有信息均不應被視為投資建議。新火種對本文可能提及或鏈接的任何項目不表示認可。 交易和投資涉及高風險,讀者在采取與本文內(nèi)容相關的任何行動之前,請務必進行充分的盡職調(diào)查。最終的決策應該基于您自己的獨立判斷。新火種不對因依賴本文觀點而產(chǎn)生的任何金錢損失負任何責任。





 新火種
2024-01-03
新火種
2024-01-03 






